壹、散熱產業演進
任何電子元件在運作之中,由於並非超導體,本身的電阻即會造成電能的損耗,而損失的電能即會轉化成熱的形式。電子元件數目越多,工作頻率越高,所產生的熱也越多,溫度也因此會逐漸升高。在早期的電腦中,由於機體內部元件數目較少,工作頻率低,以及內部空間大,僅需在機殼上開出通風口,靠著一般的空氣散熱,或是再藉助電源供應器內的風扇,即可達到散熱的目的。然而,隨著摩爾定律,CPU的電晶體數目每隔一年半即出現倍數成長,且密度大幅增加之下,運作時所產生的熱已經無法單靠機殼的風扇就可排出機體之外。由於高溫往往會造成電子元件工作失效而導致當機,因此以CPU散熱為主要目的的散熱模組產業隨即出現。
CPU在80286後期與80386前期時開始有讓CPU使用散熱片(Heat
Sink),不過除此之外x86處理器多半用新封裝、新製程的技術方式來克服散熱,使其保持不用散熱片也能正常運作。然而,80486DX-33之後,就幾乎都要使用散熱片,甚至搭配散熱風扇(Fan)來散熱。
圖一:散熱鰭片
圖二:散熱風扇

進入Pentium時代後,一般仍採用散熱片搭配散熱風扇的方式來散熱。雖然在PentiumⅡ世代時,Intel一度希望藉由PentiumⅡ卡匣型態採插槽式連接,使處理器的體積大增後,可以只用不需電力的散熱片散熱,但是由於PentiumⅡ處理器實在太熱,即便可裝置比過往處理器更厚大的散熱片,依舊無法完全因應,所以後續(266MHz以後)的PentiumⅡ仍然回歸到風扇散熱的作法。另一方面,在筆記型電腦上,由於受到空間的限制以及電持續電力的考量,無法增加風扇進行散熱,因此增加了熱導管(Heat
Pipe)的應用。直到現在,散熱模組的設計上,仍然是分成散熱片、風扇和熱導管三大部分:在桌上型電腦(DT)方面,因為內部空間較大,且機殼上也常可安裝多個風扇進行散熱,因此其散熱模組目前仍然多僅用散熱片搭配風扇為主,僅有少部分機型或是Clone市場玩家會再採用包含熱導管的散熱模組;而NB則全部是採用散熱片、風扇和熱導管結合的散熱模組。至於市面上有部分針對超高散熱需求(如會對CPU超頻、安裝多顯示卡的玩家)所開發的水冷式散熱模組,雖然散熱效率極佳,且具有安靜的優點(可大幅減少風扇的需求量),但由於目前仍有成本偏高,可靠性有疑慮的問題(冷卻液外漏將導致系統嚴重損壞),市場有限,因此暫不在本文討論範圍之內。
貳、散熱模組各元件簡介
散熱片
散熱片是散熱模組中最基礎的一項運用。雖然設計上多有不同,但基本原則是設計成多排「凹」字型並列,目的是增加散熱面積,加快散熱效率。現有的作法多是讓散熱片與電動風扇相輔搭配;以最常見的CPU散熱為例子,處理器是先透過散熱膏與散熱片相連,之後才在散熱片上端加裝電動風扇,以此來加速散熱。同樣的,熱導管技術,也依然需要與散熱片搭配,熱導管一端接觸處理器晶片的封裝表面,另一端則接觸散熱片,透過散熱片將熱消散。
散熱片材料的選擇上,多數是採用銅或是鋁。姑且不論銅價高出鋁價達三倍以上,兩種金屬在散熱運用上有著不同的取向。就熱傳導性而言,銅的表現勝於鋁,銅為390W/m-K,鋁則為209W/m-K,很明顯銅比鋁多出86.6%的熱傳導力,按理而言銅比鋁更適合用於散熱片。不過,熱傳導性並非是散熱金屬的唯一考量選擇。銅的缺點在於不易加工,不僅製程方式的選擇受限,且在銅、鋁皆可用的製程下,銅對加工器具的損耗也較大,加工時間也較長。此外,銅的質量是鋁的三倍,在今日多數的電子設計都講究短小輕薄,銅的重量也成為選用時的一大顧慮。目前一般做法上,是採行重點式使用或搭配性使用,例如散熱片的底部最接近發熱處,需要較好的熱傳導性,此部份可採用銅,使熱能更快擴散到各鰭片上,而底部之外的鰭片部份就可採用較輕、塑性與加工較易的鋁材來實現。
熱導管
熱導管本身是一個密閉的長條管狀容器,容器內裝有少許的「工作液體」,管的內壁運用技術處理使其具有「毛細結構」。長條管的一端接近發熱處,使管內的液體受熱,受熱後液體達沸點而汽化、蒸發,蒸發後的氣體朝長管的另一端移動,到達管的另一端後,氣體透過管壁將熱能釋放,釋放熱能的氣體重新回復成液體,液體附著在管壁,而管內壁具有毛細結構,液體運用毛細原理開始往下回流,重新流回長條管的另一端,也就是接近發熱處的位置。如此週而復始,形成一個自然的循環散熱系統。
圖三:熱導管構造和工作原理
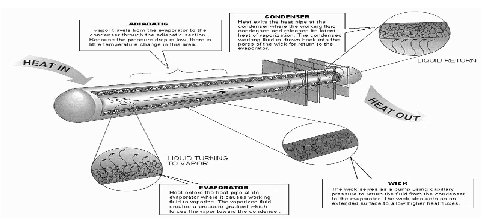
資料來源:電子時報10/30/2006,http://www.bmpcoe.org/
管材選擇上多半為銅、鋁,目前尤其以銅、無氧銅為大宗。而在毛細結構方面,事實上熱導管的主要類型區分也在毛細結構,現階段常見的毛細結構有溝槽式、網目式、纖維式、燒結式,其中又以燒結式為最佳。而在工作流體的選擇上,除了水之外,其他常見的工作流體還有甲醇、乙醇等。
風扇
散熱片和熱導管皆屬於被動式散熱裝置,因其藉由本身的物理性質進行散熱,而風扇則因需要另接電源,而屬於主動式散熱裝置。在散熱模組中的風扇,通常和散熱片相連接,目的是為了將散熱片所傳導出來的熱能加速排出,並加快機體內的熱對流速度。
風扇在結構上遠較散熱片和熱導管複雜,其組成包含了風扇葉片、外框、定子總成、轉子、驅動電路等。對於風扇的要求,在效能方面是考量散熱效率,也就是風扇轉速—轉速越快,一般來說風速越高、風壓越大,因此散熱能力越好。另一方面則是要維持穩定度,也就是及連續運轉的壽命。噪音的問題則是另一考量重點榆兜鈳t越快,噪音往往也越大;若要消除噪音卻又能維持高轉速,可在軸承和扇葉設計上變更(如用磁浮軸承替代滾珠軸承),但是代價則是成本大幅增加。此外,為了因應NB講求輕、薄的趨勢,小型化的風扇也是發展的主要方向之一。
圖四:DT散熱模組

資料來源:http://www.heatsink-guide.com/
圖五:NB散熱模組

資料來源:力致科技網站
參、散熱模組市場需求分析
CPU越來越熱,帶動散熱模組的需求
如前文所述,散熱模組產業的興起,乃是根源於CPU越來越熱,對於散熱的需求不斷提昇所致。觀察Intel歷年來所推出的CPU可以發現,在多數時間內,代表散熱需求的溫度設計功率(TDP,Thermal
Design
Power。此是代表在執行一般的應用程式之下,散熱裝置可處理的最大熱消耗功率;TDP值越高,代表CPU運作時越熱)乃是呈現不斷上升的狀況。1995年Intel推出Pentium
Pro時,TDP值為47W;然而隨著CPU的時脈不斷增加,到了Pentium
D時,TDP值已可高達130W,「熱到可以煎蛋」。Intel也警覺到此一問題,因此從Pentium D
960(3.6GHz)之後已不再強調時脈,而轉而以雙核心為設計架構,加上製程的進步,到Core2
Duo時的TDP值也降低到65W。TDP值的下降,也代表對於散熱需求的降低,可採用規格較低的散熱模組,因此對於散熱模組廠來說並不是好消息。不過,從Core2
Duo Extreme的TDP值提高到80W,剛發表的Core2
Quad四核心CPU的TDP值再度達到105W,顯示對於散熱的需求又再度增加,因此對於散熱模組產品的等級需求勢必將再提昇,有助於散熱模組廠的成長表現。
圖六:Intel DT CPU之TDP走勢

資料來源:Intel,www.wikipedia.org
除了CPU的散熱需求之外,VGA卡也有高度的散熱需求,由其是在當Intel和AMD兩大廠均把節省能源消耗視為設計要素之時,兩大繪圖晶片廠nVidia和ATI的開發方向卻不斷朝向效能更強,但是也更為耗電的GPU。舉例來說,nVidia建議採用nVidia雙顯示卡(SLI)的玩家,電源供應器的輸出功率甚至應達500W以上,以此估計雙顯示卡的功率消耗可達到3~400瓦。很明顯,目前顯示卡耗電的程度已經比CPU高出很多,而這也造成了繪圖卡的散熱需求不斷上升。在強調影像效果的Windows
Vista推出之後,對於獨立顯示卡的需求勢必將會顯著提高,這也將帶動VGA卡散熱模組的需求成長。
需求的成長仍和PC成長率接近
由於散熱模組目前仍幾乎全應用於PC領域,因此整體市場的成長性仍和PC市場的成長息息相關。根據電子時報資料的統計和預估,07年整體PC出貨預估可達2.52億台,年成長率約為10.6%,其中DT的成長趨緩,僅約有5%,主要的成長動力仍來自於NB的滲透率不斷提高,估計今年仍可達到23%。對於散熱模組市場來說,出貨量成長性則估計應可較PC成長幅度略高(因為考量Clone市場的需求);然而在產值變化方面,雖然Vista效應可望提高對於散熱模組等級的需求,對於平均單價和毛利率有正面的助益,但是市場競爭以及原物料價格對於產品單價影響的變數仍相當大。在正負面因素相互抵銷之下,康和目前仍認為產值成長率將和出貨成長率相當。
肆、我國散熱模組產業現況
目前台灣上市櫃的散熱模組產業廠商計有鴻準(2354)、建準(2421)、協禧(3071)、奇鋐(3017)、雙鴻(3324)、超眾(6230)、業強(6124)、力致(3483)和元山(6275)。其中建準和協禧是專業風扇廠,元山事業體則分成風扇和小家電兩部分;業強是專業熱導管廠;奇鋐、雙鴻、超眾皆為散熱模組專業廠,超眾同時有部分熱導管產能;力致近期才新上櫃,風扇和散熱模組營收約各半;鴻準雖然不以散熱模組為主力,但其是全球最大散熱模組廠;且其上下游零件產製完全整合,在散熱模組產業中最具競爭力。
過去兩年,台灣散熱模組產業經營普遍相當慘澹,尤其是在去年,各廠毛利率、稅前淨利率普遍大幅下降,奇鋐、雙鴻兩大廠甚至出現虧損。研究部認為主要原因有二:一是因為受到低價電腦風潮的影響,產品跌價速度加快,又受到鴻準的強力競爭,因此獲利能力大幅降低。但是更重要的因素,應是和銅、鋁等原料成本飆升有關。
圖七:Intel DT CPU之TDP走勢 圖八:Intel DT CPU之TDP走勢
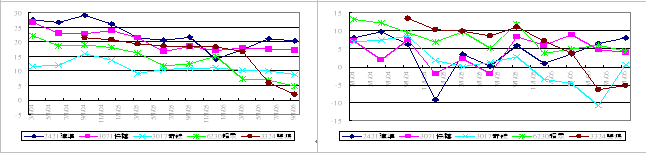
資料來源:TEJ,康和整理
散熱模組的三大組件中,散熱片和熱導管的成本比重分別在DT和NB散熱模組中高達六成和四成以上。由於散熱片和熱導管絕大多數由銅或是鋁製成,因此當原料價格快速攀升時,若成本無法向下游轉嫁,毛利率就必然快速下滑。銅價在過去兩年,由每公噸3000多美元,一度大幅飆漲到超過8000美元(近期回跌到6000美元以下),漲幅超過1倍;而鋁價也由約每公噸1900美金漲到目前約2800美金左右的價位,漲幅接近五成。原料價格的漲幅過大,造成去年各廠獲利普遍大幅下滑,其中又以散熱模組專業廠去年度受傷嚴重,奇鋐、雙鴻預期都轉盈為虧,超眾也僅有小幅盈餘。專業風扇廠由於金屬原料成本比重較低,且技術困難度較高,因此雖然也受到影響,但是獲利相對來說較為平穩。
圖九:LME近兩年銅價走勢 圖十:LME近兩年鋁價走勢

資料來源:Bloomberg
不過自從去年Q3以來,原料價格已經趨於平穩,銅價更從去年12月以來出現相當大的跌幅,因此散熱模組產業在成本面的最壞情形應該已經過去。今年在原料成本可望較去年下降,而銷售上預期又將受惠於Intel新一代CPU推出,以及Vista推出的效應之下,今年的產業展望可望較去年大幅好轉,產業的冬天即將過去。
伍、推薦個股
去年Q4起,由於市場普遍預期散熱模組廠的產業谷底將於06年落底,今年在原物料價格回跌,以及對Vista效應的期待之下,各公司的股價紛紛出現大漲。康和研究部認為,由於去年Q4各廠的財報數字應該普遍仍不理想,且目前Q1又是淡季,因此在去年Q4的期待行情結束之後,短線上並無刺激股價的動力。不過,由於今年的獲利情形應可較去年大幅好轉,且下半年的成長仍值得期待,因此研究部認為若有回檔仍可逢低佈局。
業強是專業熱導管廠,營收比重達九成以上,其他部分則為無鉛錫膏和錫球。去年前三季營收13.53億元,YoY-32.06%,稅後盈餘2.31億元,YoY-46.72%,稅後EPS
1.64元。12月營收1.28億元,月衰退高達41%,年衰退亦有21%,遠低於市場原本預期。累計Q4營收5.69億元,QoQ+6.25%。獲利方面,雖然12月起銅價大幅下滑有利於成本下降,但是具體效應估計在本季才會顯現,因此研究部預估Q4毛利率仍將呈現下滑走勢。業外部分,由於中山廠已經轉虧為盈,因此轉投資獲利應可較Q3明顯提昇。研究部預估Q4稅後盈餘1.25億元,EPS
0.88元;全年營收累計為19.26億元,YoY-23.7%,稅後盈餘3.51億元,YoY–14.6%,EPS 2.51元。
今年全年展望上,Q1是產業淡季,預估營收獲利都降較去年Q4下滑,研究部估計幅度約在10~15%之間。不過由於公司的熱導管約60%以上使用在NB,而近兩年NB的年成長率約維持2成左右,再加上受Vista
帶動,目前NB中高階繪圖晶片搭載熱導管的比率預估可從目前的2成提升至4-5成,且研究部認為下半年有機會進入Sony
PS3遊戲機的供應鍊,出貨增溫,因此下半年可望有明顯的成長。康和預估07年營收24.72億元,YoY+28.3%,稅後盈餘5.02億元,YoY+42.8%,每股稅後盈餘3.56元。由於去年獲利較不理想,且Q1仍為淡季,因此短期建議在07年本益比8-9倍區間操作;惟因市場上對於下半年Vista效應仍有期待,若題材發酵,仍可逢低買進,目標價11倍本益比。
力致是於去年底新上櫃,技術核心在於風扇技術,目前產品線為NB用散熱模組及散熱風扇,今年上半年佔合併營收分別約各半。由於掌握關鍵風扇技術,且NB散熱模組受到原物料價格影響較DT散熱模組低,另一方面公司規模經濟開始顯現,因此去年毛利率預估也能穩定維持在接近30%,是國內散熱模組產業中獲利能力最強的公司。12月營收1.65億元,MoM-14%,符合市場預期。累計力致06年合併營收19.3億元,YoY+86.1%,預估稅後EPS
7.3元。
今年展望方面,熱導管產能自給率在蘇州廠三期產能開出後將可由現在的40%提升到70%以上。也因此公司在成本掌握度提高下已正式跨入DT散熱模組領域,因此研究部認為今年度成長幅度可望超越NB平均約20~25%左右的成長率。不過因產品跌價壓力持續存在,且同業競爭激烈,因此預估毛利率仍將較去年下滑。預估力致07年合併營收26.02億元,YoY+34.3%,稅前盈餘3.07億元,YoY+40.5%,稅後EPS
10.32元。投資建議上,研究部認為力致雖然規模較同業仍有距離,但因獲利能力遠高於同業,因此合理股價本益比應可和同業相當。投資建議為Equal
Weight,以預估今年度EPS計算P/E 12~ 14X。